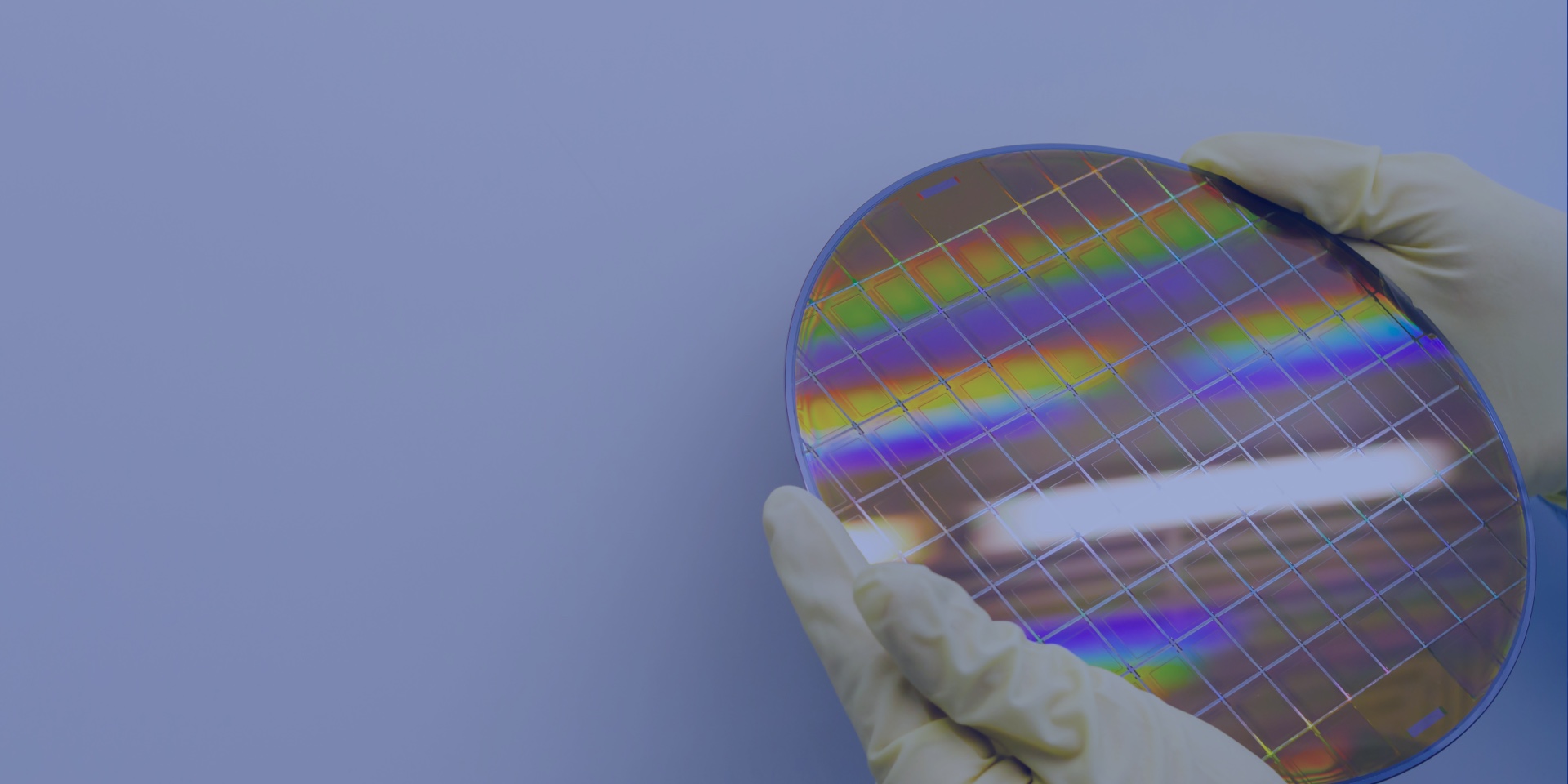
晶圆减薄,是在制作集成电路中的晶圆体减小尺寸,为了制作更复杂的集成电路。
集成电路制造技术的进步首先来源于市场需求的要求,其次是竞争的要求。在集成电路制造中,
半导体硅材料由于其资源丰富,制造成本低,工艺性好,是集成电路重要的基体材料。
从集成电路断面结构来看,大部分集成电路是在硅基体材料的浅表面层上制造。由于制造工艺的
要求,对晶片的尺寸精度、几何精度、表面洁净度以及表面微晶格结构提出很高要求。因此在几百道工
艺流程中,不可采用较薄的晶片,只能采用一定厚度的晶片在工艺过程中传递、流片。通常在集成电
路封装前,需要对晶片背面多余的基体材料去除一定的厚度。这一工艺过程称之为晶片背面减薄工
艺,对应装备就是晶片减薄机。
晶圆减薄作用:
1.通过减薄/研磨的方式对晶片衬底进行减薄,改善芯片散热效果。
2.减薄到一定厚度有利于后期封装工艺。
常规工艺:
减薄/抛光到80-100um
粗糙度: 5-20nm
平整度: ±3um

晶圆减薄机又称晶圆研磨机,属于半导体设备的一种,主要用于晶圆表面精细加工,适用于半导体硅片、电子元器件、功率器件加工等。它功能丰富,既可以快速制晶,高速磨床磨掉多余碳化物,还可以用于半导体生产和制造过程中的加工工序、用于检测电子设备的零部件。
一般而言,研磨机由抛光头、抛光盘、修整器、抛光液输送系统等部分组成,其中抛光头是复杂的部件,也被称为是纳米级技术实现的核心部件。作为晶圆的减薄工艺之一,研磨不仅能减少晶圆的厚度,也是解决前后端出现的工艺问题。